摘要
可變角度橢圓偏振光譜儀(VASE)是一種常用的技術,由於其對光學參數的微小變化具有高靈敏度,而被用在許多使用薄膜結構的應用中,如半導體、光學塗層、資料存儲、平板製造等。在本案例中,我們演示了VirtualLab Fusion中的橢圓偏振分析器在二氧化矽(SiO2)塗層上的使用。對於系統的參數,我們參考Woollam等人的工作 "可變角度橢圓偏振光譜儀(VASE)概述。I. 基本理論和典型應用",並研究該方法對輕微變化的塗層厚度有多敏感。
任務描述
鍍膜樣品
橢圓偏振分析儀
總結 - 組件...
橢圓偏振係數測量
橢圓偏振分析儀測量反射係數(s-和p-極化分量)的比率????,並輸出相位差????,以及振幅分量Ψ,根據
在VirtualLab Fusion中,複數係數 和 和 是通過應用嚴格耦合波分析(RCWA),也被稱為傅立葉模態法(FMM)來計算。因此,在研究光柵樣品的情況下,這些係數也可以是特定繞射階數的瑞利係數。 是通過應用嚴格耦合波分析(RCWA),也被稱為傅立葉模態法(FMM)來計算。因此,在研究光柵樣品的情況下,這些係數也可以是特定繞射階數的瑞利係數。
橢圓偏振對小厚度變化的敏感性
為了評估橢偏儀對塗層厚度即使是非常小的變化的敏感性,對10奈米厚的二氧化矽層和10.1奈米厚的二氧化矽膜的結果進行了比較。即使是厚度的微小變化,1埃的差異也高於普通橢圓偏振的解析度(0.02°為 ,0.1°為 ,0.1°為 )。因此,即使是塗層中的亞奈米變化也可以通過橢偏儀來測量。 )。因此,即使是塗層中的亞奈米變化也可以通過橢偏儀來測量。
* 數值根據Woollam et al., Proc. SPIE 10294, 1029402 (1999)
模擬結果與參考文獻的比較
被研究的SiO2層厚度變化為1埃時, 和 和 的差異。 的差異。
|


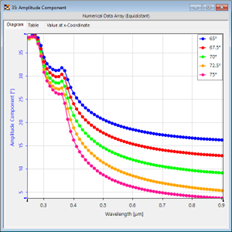
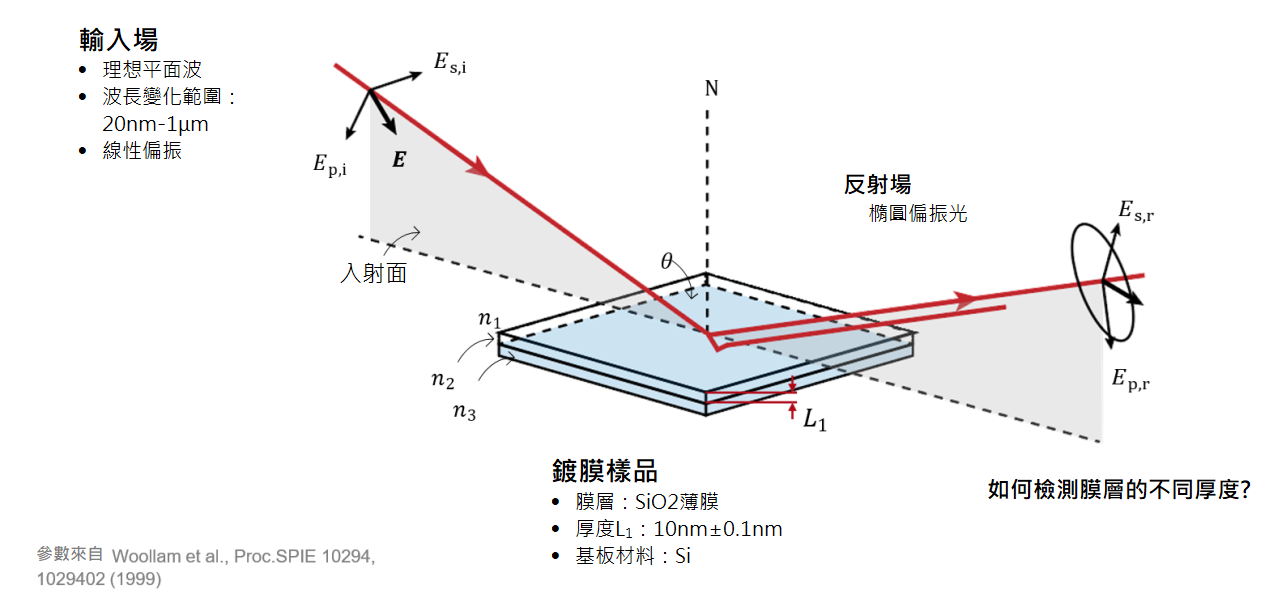

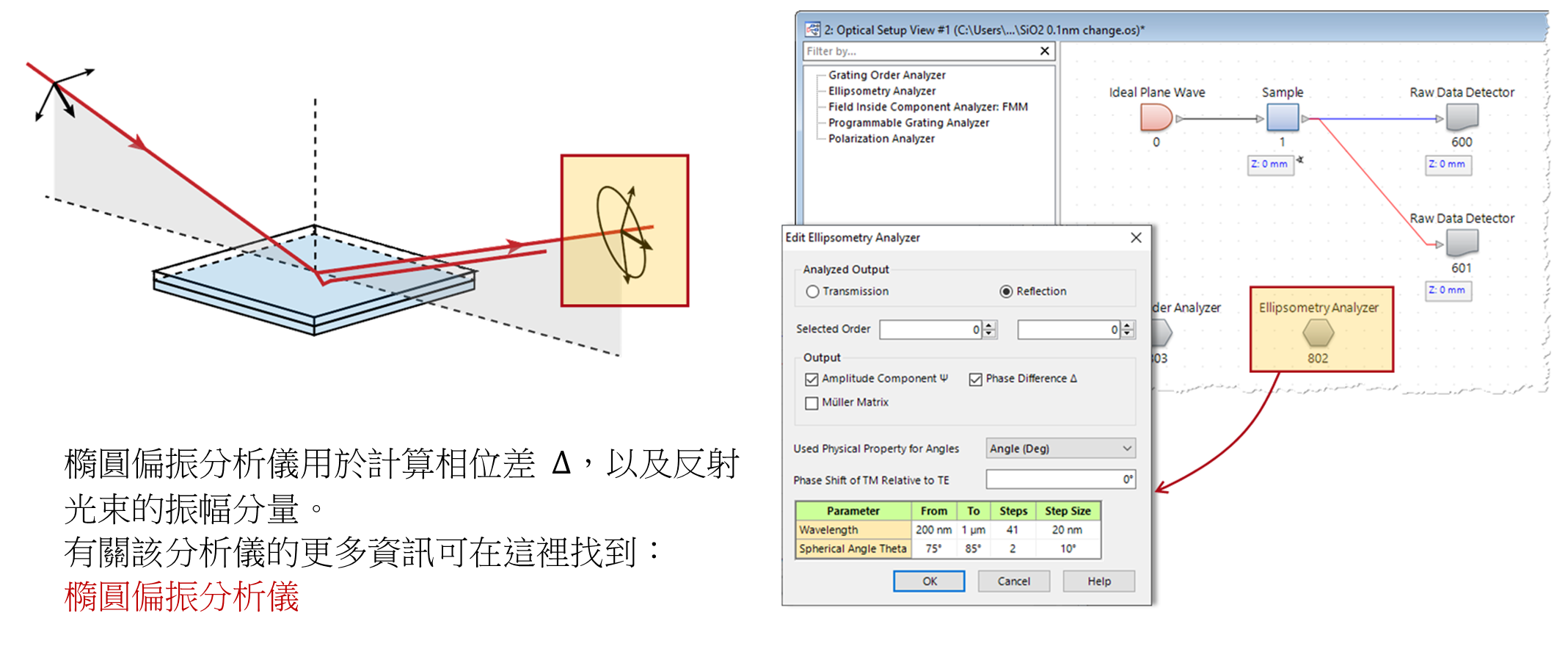


 和
和 是通過應用嚴格耦合波分析(RCWA),也被稱為傅立葉模態法(FMM)來計算。因此,在研究光柵樣品的情況下,這些係數也可以是特定繞射階數的瑞利係數。
是通過應用嚴格耦合波分析(RCWA),也被稱為傅立葉模態法(FMM)來計算。因此,在研究光柵樣品的情況下,這些係數也可以是特定繞射階數的瑞利係數。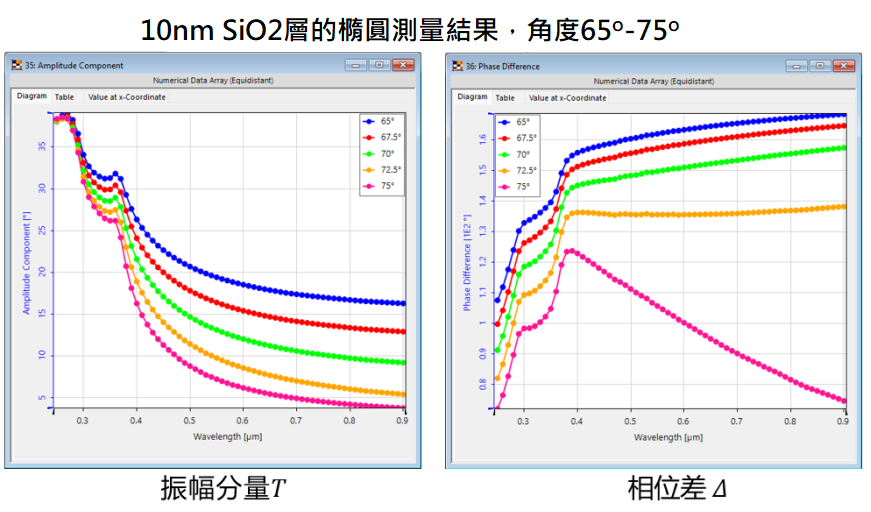
 ,0.1°為
,0.1°為 )。因此,即使是塗層中的亞奈米變化也可以通過橢偏儀來測量。
)。因此,即使是塗層中的亞奈米變化也可以通過橢偏儀來測量。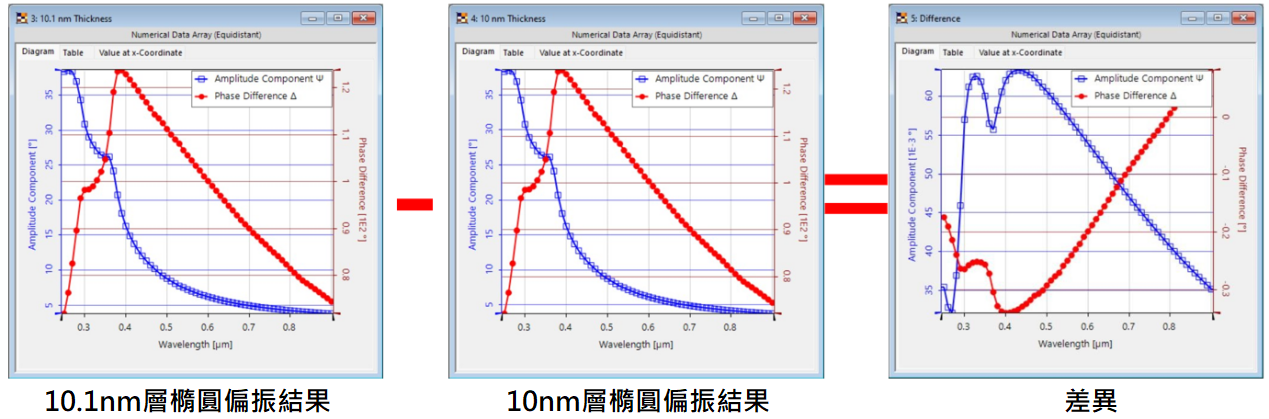
 和
和 的差異。
的差異。